2025. 5. 7. 19:28ㆍ반도체 후공정
1. 컨벤셔널 패키징 재료
(3) 접착제
※ 요변성(Thixotropy) : 고분자 물질이 외력에 의한 구조변화로 점도가 변화하는 정도
점도(Viscosity) : 유체의 끈끈거리는 정도
1) 조건
① 신뢰성 ↑ : 접착력↑ 흡습율↓ 이온불순물↓ 기계적 물성 최적화(Tg, CTE, Modulus)
② 공정 품질 확보 : 재료 흐름성↑ 접착 계면 Wettability↑ Void 발생↓ 계면 접착력↑
=> 점도, 요변성(Thixotropy), 경화 특성 최적화 필요
③ 액상 접착제 사용시 주의사항
- Bond line : 칩이 Pad에 접착된 부분
- Fillet : 액상인 접착제의 표면장력 때문에 칩 옆에 형성
ㄴ 칩 4면에 고루 형성돼야함 + 칩 윗면까지 Overflow 방지해야함
- 접착면 Void 없어야함
ㄴ발생원인 : 경화시 Solvent 휘발, 분자량 작은 폴리머 기화
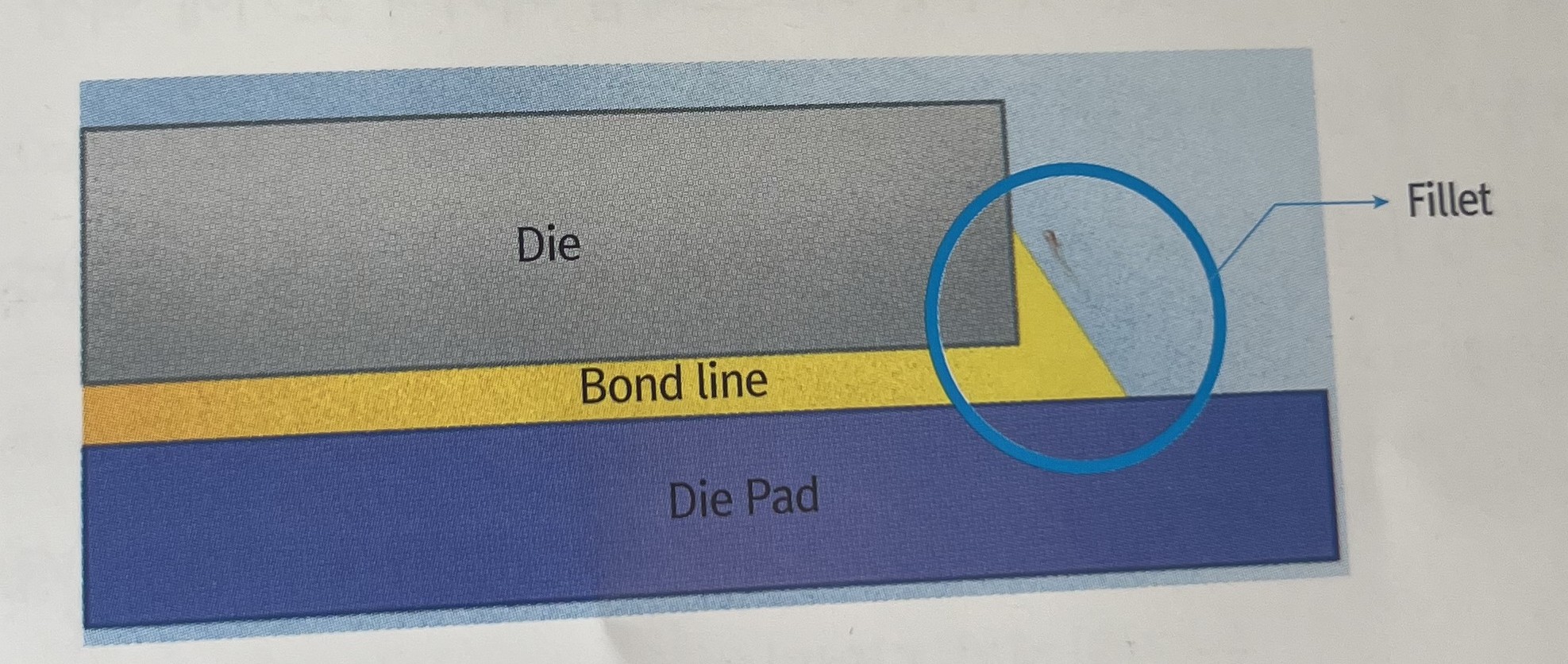
2) 분류
① 상태
a) 액상 접착제 vs 고상 접착제
| 물성 | 액상 | 고상 |
| 형태 | Paste Type | Tape/Film Type |
| 경화 | 열경화성 Epoxy / Silicone | 열 경화성 Epoxy |
| 충진재 | Sillica | Sillica |
| 적용 방법 | Stencil Printing | Laminating |
| 종류 | Adhesive | LOC Tape, Spacer Tape, DAF (WBL) |
b) 액상 접착제 종류
| 종류 | Epoxy Adhesive(B-Stage Cure Type) | Silicone Adhesive |
| Resin | 열 경화성 Epoxy, Rubber | Si-Vinyl, Si-H |
| 경화 반응 | 에폭시-경화제 중합반응 | Pt 촉매에 의한 열 경화 반응 (매우 빠름) |
| 충진재 | Silica | Silica |
| 경화 속도 조절 | 촉매 | 촉매, 경화지연제 |
| 특징 | Cure 반응 속도↓ : B-stage 유지 O | 환경 유해물질 X Cure 공정 생략 가능 |
c) 고상 접착제 종류

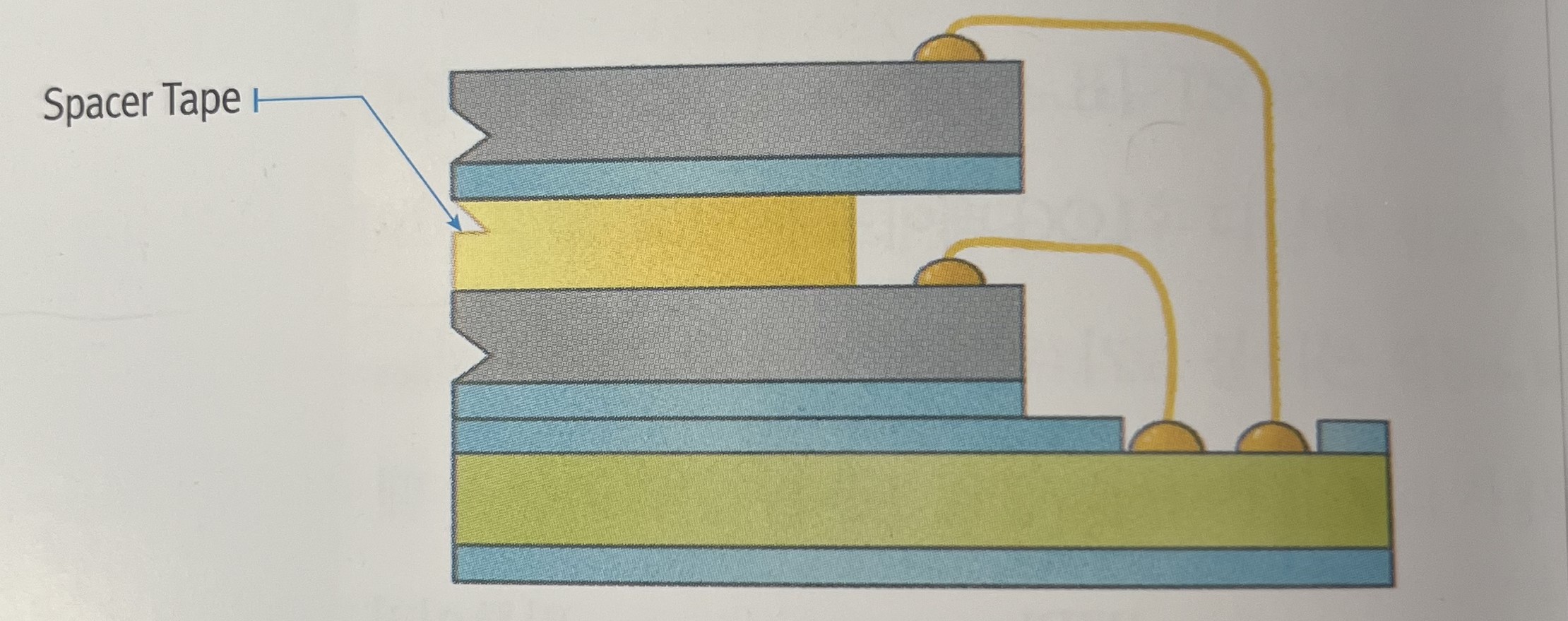
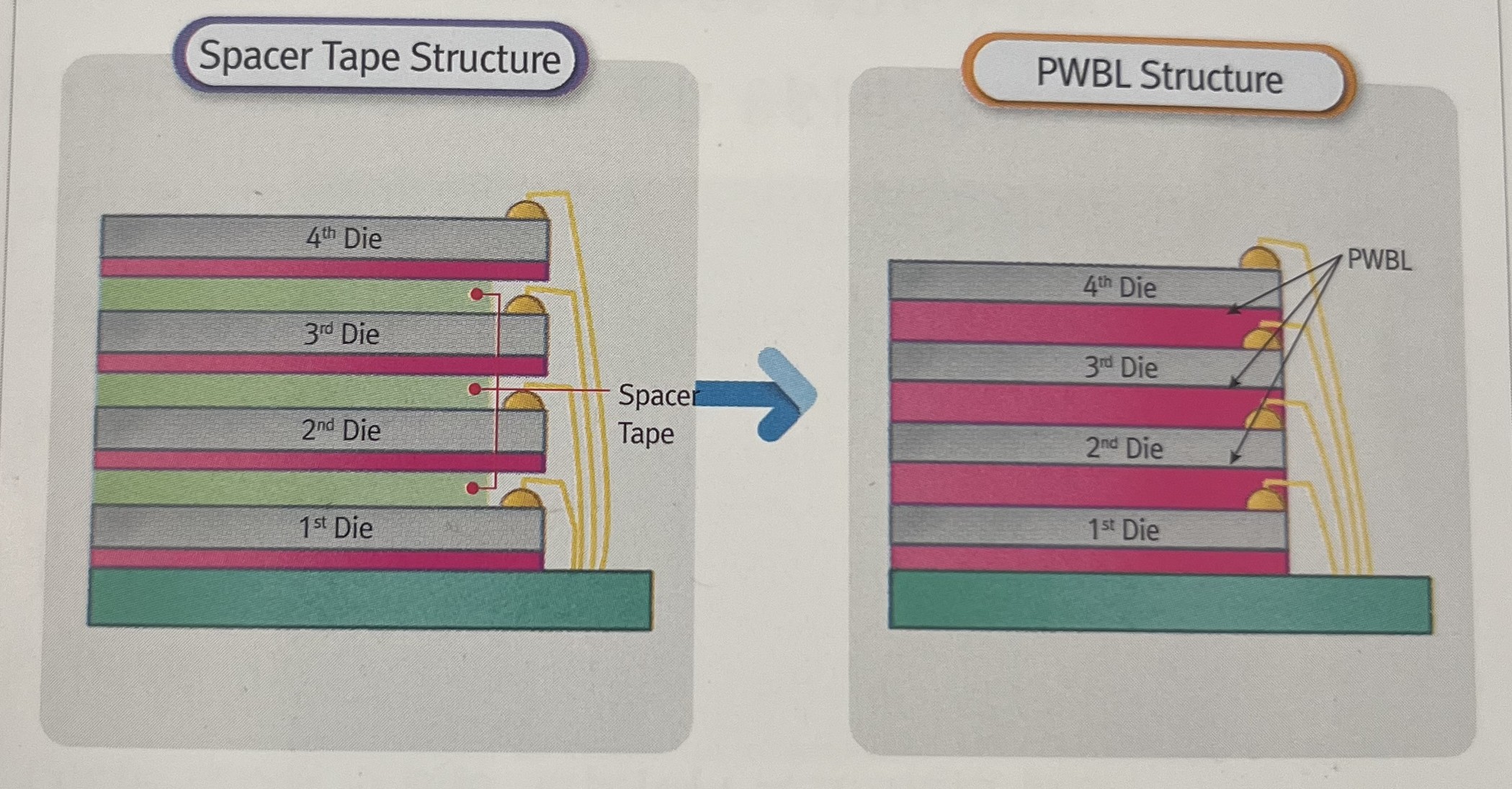
- 스페이서 테이프 : 와이어가 상부칩 아래면에 접촉되는 것 방지
(접촉시 Si, 와이어 접촉으로 전기 쇼트 발생)
- DAF(WBL) : 다이싱 테이프 + 접착 필름
기존 동일 크기 칩 적층시 스페이서 테이프(칩간 간격) + DAF(적층)
ㄴ 공정 복잡, 비용↑
=> PWBL(Penetration WBL) 등장
- PWBL (스페이서 테이프 기능 탑재된 WBL)
: Wire bonding에서 가열된 와이어가 PWBL에 접촉
=> 접착제 점도↓ => 와이어 관통해 하부칩 부착
② 구조
a) 무기 접착제 : 무기물(규산염, 인)을 이용
b) 고분자 접착제 : 열 경화성 수지 / 열 가소성 수지
③ 기능
a) 전도성 접착제 : 전도성 무기 충진제(ex. 은) 첨가 - 전도성 O
b) 비전도성 접착제 : 비전도성 무기 충진제(ex. Sillica) 첨가 - 절연성 O
④ 경화 정도
a) A-stage : 상온 끈적임 / 접착력 X
b) B-stage (반경화 상태) : 일정온도 끈적임 / 접착력 가질 수 O
c) C-stage (완전경화 상태) : 화학적특성 변화 X
※무기충진제 : 강도, 내구성, 비용 절감 등을 위해 기초 재료에 첨가되는 불활성 무기 물질
열 경화성 에폭시 : 고온에서 경화가 시작 되며, 폴리머 Cross linking이 시작돼 고강도로 경화됨.
(4) 에폭시 몰딩 컴파운드 (EMC)
1) 역할 (+갖춰야할 조건)
① Chip 물리·화학적 보호
② 원하는 형상으로 쉽게 성형
③ 접착성 (Substrate, Chip)
④ 효과적인 열방출
2) 조절 인자
① 필러(Sillica) vs 에폭시 수지
a) 필러 ↑ : 열전도도 ↑ 열팽창 계수↓ (EMC 기준)
b) 에폭시 수지 ↑ : 열전도도 ↓ 열팽창 계수 ↑
② 열팽창 계수
a) EMC > Substrate : Crying
b) EMC < Substrate : Smile
③ Substrate 열팽창 계수
Cu 배선 면적 ↑ : 열팽창 계수 ↑
3) 형태
① Tablet : Transfer 몰딩
② Powder/Granule : Compression 몰딩, Wafer 몰딩
③ Liquid : Wafer 몰딩
(5) 솔더(Solder)
1) 요구사항
① 합금 조성 균일 : T/C(Thermal cycle) <-> Drop충격 신뢰성 영향
a) Ag ↑ : TC 저항력 ↑
b) Ag ↓ : Drop 충격 저항력 ↑
② 내산화성 : Reflow중 산화막 발생 -> 볼이 제대로 붙지 X (미싱볼)
a) Flux 이용 (산화막 제거)
b) Reflow시 N2 분위기 조성
③ Void 없어야 함
a) Void 존재시, Solder 양 ↓ -> Solder 접합부 신뢰성 ↓
b) Solder ball 크기 균일해야함
④ Solder ball 표면 오염물 / 덴드라이트 성장물 없어야함
: 불량률, 접합부 신뢰성 영향
2) 조성
① Pb-Sn : 기계적 성질↑ 전기 전도도↑ (유해)
② Sn-Ag-Cu : 현재 쓰이는 구성
3) 금속간 화합물
Sn계 Solder ball : Pad의 Cu와 반응해 화합물 형성
(장점) 강도↑: 접합 강도↑
(문제점) 연성↓ : 균열 ↑ (Fatigue distruction 취약)
(6) 테이프
PSA(Pressure Sensitive Adhesive)
a) 점착 : 응집력, 탄력 => 접착/박리 가능 (일시적 접착)
b) UV에 반응 : 접착력 ↓
c) 백 그라인딩 테이프, 절삭 테이프에 이용
d) 기존 : 백 그라인딩 후 절삭테이프에 웨이퍼 붙임
현재 : 백 그라인딩 후 WBL film + 절삭 테이프에 웨이퍼 붙임
(7) 와이어
| Au | Cu |
| ① 전성(얇게 펴지는)↑ 연성(길게 늘어나는)↑ => 와이어 연결 공정 용이 ② 내산화성↑ :신뢰성↑ ③ 전기전도도↑ ④ But, 제조 비용 문제 (너무 얇으면 또 끊어짐) |
① 전성, 연성은 조금 ↓ ② 전기전도도 ↑ ③ 산화 ↑ => 장비 밀폐 + N2 가스 채워야함 |
출처 : 반도체의 부가가치를 올리는 반도체 패키지와 테스트(서민석)
'반도체 후공정' 카테고리의 다른 글
| 반도체 패키지 재료 Ⅲ (0) | 2025.05.08 |
|---|---|
| 반도체 패키지 재료 Ⅰ (6) | 2025.05.06 |
| 반도체 패키징 공정 Ⅳ (2) | 2025.05.03 |
| 반도체 패키징 공정 Ⅲ (0) | 2025.02.03 |
| 반도체 패키징 공정 Ⅱ (0) | 2025.01.27 |